ASMLジャパン、45nmプロセスの量産に対応した液浸リソグラフィーシステムを2006年第1四半期に投入──開口数1.2の反射屈折レンズを開発
2005年07月13日 19時48分更新
エーエスエムエル・ジャパン(ASMLジャパン)(株)は12日、液浸リソグラフィーシステムの最新機種『TWINSCAN XT:1700i』を発表した。ASMLジャパンは、オランダに本社を置くASML Holding(ASMLホールディング)社の日本法人。TWINSCAN XT:1700iは半導体製造業者に対して、2006年第1四半期から出荷する予定。
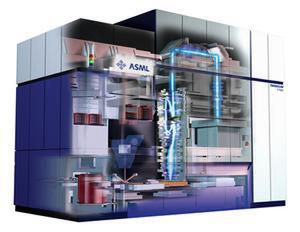 |
|---|
| TWINSCAN XT:1700i |
リソグラフィーシステムは、半導体ウエハーに回路パターンを焼き付けるために使用する装置で、最先端のプロセスではウエハーとレンズの間に液体(浸水液)を通すことでより微細な加工ができる“液浸”タイプが用いられている。TWINSCAN XT:1700iは、露光波長193nmの液浸スキャナーで、45nmプロセスを利用した半導体チップの量産に対応する。
XT:1700iでは、レンズの開口数(NA)が従来システム(XT:1400i)の0.93から1.2に大幅に向上した。これにより回路パターンを書き込む際の解像度を約30%向上できるという(50nm間隔から45nm間隔)。液浸リソグラフィーシステムでは、7月1日にニコン(株)が開口数1.07の製品を2005年第4四半期に投入すると表明しているが、今回の製品はこれを上回る数値となる。装置に用いられている反射屈折レンズの設計は独Carl Zeiss SMT社と共同で行なった。
最大露光サイズは26×33mm。フォーカス調整や出力時には乾いた状態で行ない、露光時のみに液体を利用する“Dual Stage TWINSCANプラットフォーム”により、45nmプロセスを利用した場合1時間あたり122枚のウエハーを生産することが可能。スループットは従来装置と同等で、ドライ露光(1時間あたり140ウエハー程度)に迫るという。



































