ロードマップでわかる!当世プロセッサー事情 第856回
1400WのモンスターGPU「Instinct MI350」の正体、AMDが選んだ効率を捨ててでも1.9倍の性能向上を獲る戦略
2026年03月02日 12時00分更新
前回までは、半導体に関する最高峰の国際学会「IEDM 2026」で発表された話を説明してきたが、その間に、半導体のオリンピックこと集積回路国際学会「ISSCC 2026」が閉幕した。そこで、今回からISSCCで発表された話を説明していこう。
初回は、Session 2-1 "AMD Instinct MI350 Series GPUs: CDNA 4-Based 3D-Stacked 3nm XCDs and 6nm IODs for AI applications"の内容である。前回がちょうどAMD Instinct MI300Xをテーマにしたチップレットの構築だったので、これがAMD Instinct MI350Xでどう変わったかなども加味する形で解説したい。
驚異のTBP 1400W!
AMD MI350シリーズが描く次世代AI基盤の姿
まずMI350シリーズの基本的な特徴が下の画像だ。MI300シリーズと比較して1.9倍のピーク性能であるが、TBPは750W→1400Wと大幅に増えている関係で、性能/消費電力比そのもので言えばほぼ変わらない(1%ほど向上している程度)になっている。
構造上は、XCDが8つなのは変わらない。ところがMI300シリーズはIODが4つで1個のIODにXCDが2つ搭載される形だったのが、MI350シリーズではIODが大型化され、IODの数そのものは2つに。そしてそれぞれのIODにXCDが4つずつ搭載される構成になっている。
MI350の構造図が下の画像だ。MI300シリーズの構造と比較しても大きな違いがない。もともとMI300Xの時点で、4つのIODをカバーするようなシリコン・インターポーザー(CoWoS-Sで製造)があり、その上でIOD同士の接続される形態だったし、IODの上にXCDが載る構造も同じである。おそらくIOD同士の接続や、IODとXCDの接続の形態はMI300シリーズに準ずる構造になっているものと考えられる。
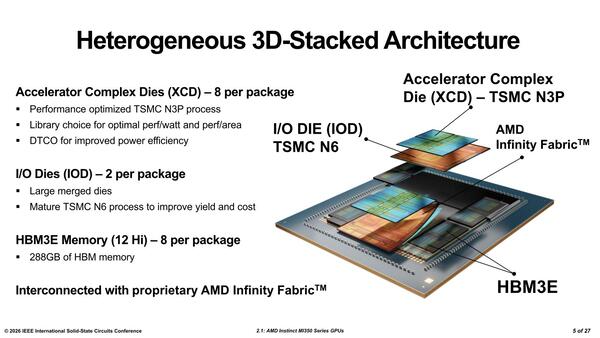
この構造図では横方向のIoD同士の接続がないので、間に配線がないのが違いと言えば違いか。MI300シリーズではXCD/CCDの脇にダミーのダイが明記されていた。MI350シリーズでもダミーダイは存在するものと思われる
では違いがないのか? というとそんなことはなく、XCDはいろいろと異なっている。MI300シリーズとMI350シリーズのXCDの構成を比較したのが下の画像である。
当然プロセスはTSMC N5からTSMC N3Pになってトランジスタ密度は上がっているのだが、エリアサイズはMI300Xと同じ110mm2に抑えられている。これはおそらくIODの大きさに制限があるため、現実問題として110mm2程度が実装できる限界なのだろうと想像される。配線層は15層から17層になっているが、これはプロセスの特性に起因するためである。
一番おもしろいのはMI300Xでは物理的に40CU(Compute Unit)を実装しており、うち2つが冗長CUで有効38CUなのだが、MI355Xでは物理36CUで、うち4CUが冗長CUとなり、実効32CUであることだ。どちらも4MBのL2+グローバルリソースの大きさはほぼ変わらず、実質的にCUあたりの面積が11%ほど拡大している計算になる。
そもそもTSMCはN5→N3Bでロジック密度が70%向上すると説明しており、N3PはN3Bと比較してやや密度向上(数値は示していない)していることを考えると、トランジスタの数は最大倍近くになっているという計算が成り立つ。
もっともこれはトランジスタの面積だけを計算した場合で、配線密度はそこまで向上しないため実際のトランジスタ数の増加はもっと少ない(次のスライドでは30%増しという数字が出てくる)が、CUの数を増やすのではなく、CUあたりの性能を向上させる方にトランジスタを費やしたことがわかる。
このあたりの損得勘定は難しい。CUを増やすのとCUあたりの性能を引き上げるの、どちらがトータルで性能を上げやすいかのシミュレーションを繰り返した結果だろうが、結果としてCUを減らしてでもCUあたりの性能を上げる方が得策と判断されたものと思われる。
またMXFP6/MXFP4のサポートに関しては、完全に従来の演算器(FP8/FP16/BF16など)との共用でも、専用ユニットを追加するのではなく、適切な中間地点を選んだと説明されている。

この連載の記事
-
第864回
PC
なぜAMDはチップレットで勝利したのか? 2万ドルのウェハーから逆算する経済的合理性 -
第863回
PC
銅配線はなぜ限界なのか? ルテニウムへの移行で変わる半導体製造の常識と課題 -
第862回
PC
「ビル100階建て相当」の超難工事! DRAM微細化が限界を超え前人未到の垂直化へ突入 -
第861回
PC
INT4量子化+高度な電圧管理で消費電力60%削減かつ90%性能アップ! Snapdragon X2 Eliteの最先端技術を解説 -
第860回
PC
NVIDIAのVeraとRubinはPCIe Gen6対応、176スレッドの新アーキテクチャー搭載! 最高クラスの性能でAI開発を革新 -
第859回
デジタル
組み込み向けのAMD Ryzen AI Embedded P100シリーズはZen 5を最大6コア搭載で、最大50TOPSのNPU性能を実現 -
第858回
デジタル
CES 2026で実機を披露! AMDが発表した最先端AIラックHeliosの最新仕様を独自解説 -
第857回
PC
FinFETを超えるGAA構造の威力! Samsung推進のMBCFETが実現する高性能チップの未来 -
第856回
PC
Rubin Ultra搭載Kyber Rackが放つ100PFlops級ハイスペック性能と3600GB/s超NVLink接続の秘密を解析 -
第855回
PC
配線太さがジュース缶並み!? 800V DC供給で電力損失7~10%削減を可能にする次世代データセンターラック技術 - この連載の一覧へ