セイコーインスツルメンツ(株)は29日、50~300mmウェハ対応のモニタリングSEM(Scanning Electron Microscope:走査型電子顕微鏡)機能付き高性能走査イオン顕微鏡(FIB:Focused Ion Beam)『SMI2000MSシリーズ』を12月5日に発売すると発表した。価格は1億1500万円からとなる。
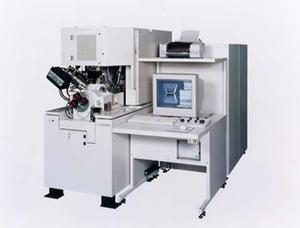 |
|---|
| 『SMI2000MSシリーズ』 |
走査型イオン顕微鏡は、ウェハ表面にイオンビームを走査(照射)することで、LSIの表面にサブμmからμmサイズの微小な穴あけを行ない、その断面を観察できる装置。不良個所の解析や、高分解能観察の解析手段として使用できる。
『SMI2000MSシリーズ』は、0.1μmレベルでの半導体の歩留まり向上やプロセス開発期間の短縮を支援する装置。走査イオン顕微鏡で微小欠陥箇所を加工しながら、55度傾いた走査型電子顕微鏡(SEM)で同一箇所をリアルタイムに観察でき、加工仕上げ面の検出(終点検出)が可能になる。SEM観察像の自動保存や、加工中の観察倍率と観察位置の変更なども行なえる。これによりピンポイントの断面観察やTEM(透過型電子顕微鏡)試料作製が確実、簡単に行なえるという。












































