半導体の実装技術に関する展示会“'98
実装プロセステクノロジー展”が、千葉・幕張メッセで開幕した。出展企業は100社。展示とともに、技術セミナーも開催する。会期は16日まで。
同展示会は今回が第1回目。展示は半導体や電子機器の実装機器、検査・試験装置が中心で、特にBGA(Ball
Grid Array)パッケージおよび、BGA/LGA(Land Grid Array)/SON(Small Outline
Non-leaded package)などのパッケージをさらに小型化したCSP(Chip Size
Package)パッケージの関連機器が目立っている。
BGAは携帯情報端末などに広く利用されているパッケージで、チップの裏面全体に、小さな球状の端子が格子状に並んだ構造をとっている。半導体は小型化、高密度化の方向に向かっているが、BGAはその両方に対応できるということもあり、現在広く利用されている。CSPの中心も、BGAの端子のピッチを狭めたFineline
BGAとなっているようだ。
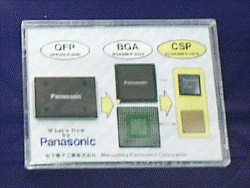 |
|---|
富士通(株)は、0.75mmピッチ、48ピンタイプの“Super CSP”を展示している。このパッケージは製造プロセスが従来と異なっているのが特徴だ。従来、パッケージングはチップごとに施されていたが、Super
CSPではウエハー状態のまま、複数のチップを一括してパッケージングするため、製造工程や材料が省略できる利点がある。このようなパッケージは“ウエハーレベルパッケージ”と呼ばれ、現在、国内外の企業で移行が進められている。
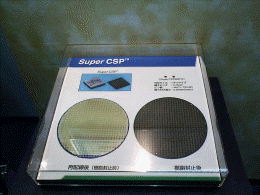 |
|---|
| “Super CSP”。ここでは0.75mmピッチであるが、0.5mmピッチのCSPの開発も進めているという |
また、今後の実装技術にとって、環境への取り組みも大きなテーマとなっている。中でも、毒性の強い鉛(Pb)を極力使用しないようにする“鉛フリー”の動きが、展示会でもちらほら見える。千住金属工業(株)は、鉛フリーはんだを展示。(株)タムラ製作所のブースでも、鉛フリーのはんだ付プロセスを前面に押し出していた。鉛に代わるはんだ成分としては、銀(AG)が有力視されており、Sn(すず)-AG系のはんだ合金の実用化も進んでいる。
 |
|---|
| 千住金属工業の鉛フリーはんだ『ECO SOLDER M31』シリーズ |
最後に、基調講演についても報告する。東京大学先端科学技術センターの須賀唯知教授は、実装技術に関する国家プロジェクトをテーマに講演した。
 |
|---|
| 須賀唯知氏 |
須賀氏はエレクトロニクス実装学会や、電子実装工学研究所などの設立によって、昨年来、実装に関する技術ネットワークが強化されてきたことを紹介。また、自身の研究分野である“常温接合”についても時間を割いた。
この研究は、金属やプラスチックの表面を活性化させることで、異種デバイスの接合を可能にするもの。これにより、異種デバイスの多層構造を持つチップの製造が実現できるという。同氏は、このチップの形成する3D集積回路を、「高コストにならざるをえないシステムLSIの対抗馬」として打ち出した。











































